暑期实践探秘晶圆减薄过程
作为一名兰州理工大学电气工程与信息工程学院的研究生,我有幸参加了天水华天科技的暑期社会实践。作为国内重点集成电路封装测试企业之一,其封装能力与技术水平在国内也是名列前茅。在这段实习期间,我主要深入了解了集成电路封装的各个环节,其中最令我着迷的是参观晶圆减薄过程。
晶圆减薄是半导体封装制程中的一项重要步骤,其主要作用是将已经制作完成的芯片(晶圆)进行切割和减薄,使其达到所需的最终厚度。这一过程在集成电路生产中扮演着关键的角色,具有以下几个重要作用:1. 厚度控制;2. 降低成本;3. 优化性能;4. 提高散热性能;5. 便于封装。它确保了芯片的精确尺寸和性能。
减薄工艺的主要流程是先将晶圆通过贴膜机进行正面贴膜,这一步的主要作用是保护晶圆正面图形不受损伤。再通过减薄机吸附将晶圆背面进行研磨,这个步骤主要分为粗磨和精磨两部分。
因为集成电路封装的前端是在无尘车间进行的,我们必须穿上无尘防护服和口罩等防护用品,经过风淋室,才可进入产线。在参观中,我们得以近距离观察晶圆减薄的工艺流程和先进设备的运作。华天科技的工程师们耐心地向我们解释了每个步骤的重要性和操作要点。从材料选择、设备调试,再到实际操作,整个过程充满了挑战和技术含量。
我深深感受到晶圆减薄过程的复杂性和精密性。一丝不慎,都可能导致芯片损坏,影响整个生产线的效率。华天科技作为一家多年经验丰富的企业,在这个领域中拥有着非常高的技术实力和严谨的质量管理。
参观结束后,我对于集成电路封装测试行业有了更深入的认识,晶圆减薄这一环节让我感受到了科技的魅力和挑战。我由衷感谢华天科技为我们提供了这次宝贵的实地学习机会,让我们能够更贴近实际工作,拓宽知识视野。
这次实习不仅让我学到了专业知识,更增强了我团队合作和解决问题的能力。在未来的学习和工作中,我将努力将所学应用到实践中,为集成电路封测行业的进步贡献自己的一份力量。
感谢学校和天水华天科技给予我们这次难忘的实习体验!

进入无尘车间前,穿上防护服,准备进入风淋室

晶圆减薄是半导体封装制程中的一项重要步骤,其主要作用是将已经制作完成的芯片(晶圆)进行切割和减薄,使其达到所需的最终厚度。这一过程在集成电路生产中扮演着关键的角色,具有以下几个重要作用:1. 厚度控制;2. 降低成本;3. 优化性能;4. 提高散热性能;5. 便于封装。它确保了芯片的精确尺寸和性能。
减薄工艺的主要流程是先将晶圆通过贴膜机进行正面贴膜,这一步的主要作用是保护晶圆正面图形不受损伤。再通过减薄机吸附将晶圆背面进行研磨,这个步骤主要分为粗磨和精磨两部分。
因为集成电路封装的前端是在无尘车间进行的,我们必须穿上无尘防护服和口罩等防护用品,经过风淋室,才可进入产线。在参观中,我们得以近距离观察晶圆减薄的工艺流程和先进设备的运作。华天科技的工程师们耐心地向我们解释了每个步骤的重要性和操作要点。从材料选择、设备调试,再到实际操作,整个过程充满了挑战和技术含量。
我深深感受到晶圆减薄过程的复杂性和精密性。一丝不慎,都可能导致芯片损坏,影响整个生产线的效率。华天科技作为一家多年经验丰富的企业,在这个领域中拥有着非常高的技术实力和严谨的质量管理。
参观结束后,我对于集成电路封装测试行业有了更深入的认识,晶圆减薄这一环节让我感受到了科技的魅力和挑战。我由衷感谢华天科技为我们提供了这次宝贵的实地学习机会,让我们能够更贴近实际工作,拓宽知识视野。
这次实习不仅让我学到了专业知识,更增强了我团队合作和解决问题的能力。在未来的学习和工作中,我将努力将所学应用到实践中,为集成电路封测行业的进步贡献自己的一份力量。
感谢学校和天水华天科技给予我们这次难忘的实习体验!

进入无尘车间前,穿上防护服,准备进入风淋室

参观贴膜机
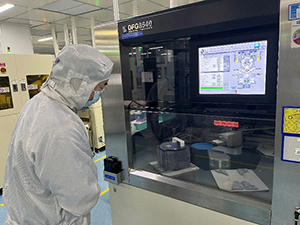
参过晶圆减薄研磨过程
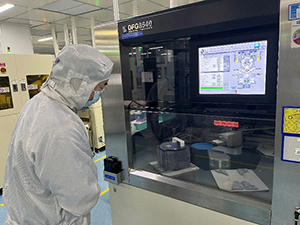
参过晶圆减薄研磨过程
- 作者:温润玉 来源:兰州理工大学电气工程与信息工程学院
- 发布时间:2023-07-25 浏览:182
- 暑期实践探秘晶圆减薄过程
- 兰州理工大学电气工程与信息工程学院2023暑期社会实践
- 07-25 关注:0
- 安全教育没有终点
- 2023年7月3日湖北第二师范学院楚音汉蕴暑期社会实践队队员来到湖北省武汉市江夏区湖口社区,对当地的中小学生进行了防诈骗的安全宣讲活
- 07-25 关注:2
- 曲园学子走进门文化 缩短青少年与“乡村门”的距离
- 07-25 关注:4
- 以使命挺立于战火之际,似曙光照耀着西北大地
- 感悟西北联大精神
- 07-25 关注:8
- 学习雷锋精神,弘扬传统美德
- 2023年7月8日,河南工业大学“红弘鸿宏”暑期社会实践团队与川塘社区联合进行了”学习雷锋精神,弘扬传统美德“
- 07-24 关注:4
- 三下乡(二)之弦歌不辍,薪火相传
- 2023年7月8日晚上,我们团队去到了邵阳市隆回县虎形山瑶族乡乡村印记里的篝火晚会。
- 07-24 关注:7
- 三下乡(一)之“乡”约盛夏,追寻山歌足迹
- 2023年7月8日邵阳市隆回县虎形山瑶族乡草原村“云上花瑶,寻根铸魂”乡村振兴促进团去到大坨村采访了当地的老艺人黄一良老师。
- 07-24 关注:6
- 美丽花瑶,惬意生活
-      “云上花瑶,寻根铸魂”,我们邵阳学院音乐舞蹈学院乡村振兴促进团来到了邵阳市隆回县虎形山瑶族乡。这里的美是纯
- 07-24 关注:9





